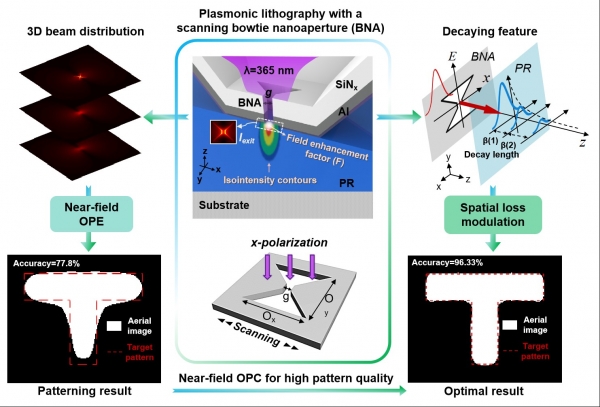
近场光学邻近效应对表面等离子体光刻曝光结果的影响及基于高频倏逝波信息空间调制式的OPC优化方法
表面等离子体光刻(Plasmonic lithography)作为一种近场成像技术,具有可打破衍射极限的特性,能够为发展高分辨率、低成本、高效、大面积纳米光刻技术提供重要方法和技术途径,是下一代光刻技术的主要候选方案之一。目前,虽然已通过实验验证表面等离子体光刻可以满足微纳制造领域对14 nm及以下技术节点分辨率的要求,但随着集成电路特征尺寸的进一步缩小,严重的近场光学邻近效应(Near-field optical proximity effect,near-field OPE)不仅会降低曝光图形的分辨率,而且会增大曝光图形的失真现象,造成纳米器件物理性能及电学特性的偏差,进而影响到产品的功能和成品率,限制了表面等离子体光刻技术的实际应用性。
为满足集成电路中对纳米结构器件的尺寸及质量的高性能要求,有效地解决表面等离子体光刻技术中存在的near-field OPE问题,中国科学院大学集成电路学院教授韦亚一课题组通过对表面等离子体光刻特有的近场增强效应进行定量表征,从物理根源上揭示了near-field OPE的产生机理,以及倏逝波(Evanescent waves)复杂的衰减特性和场分布的不对称性对曝光图形边缘特征尺寸的影响,并从光刻参数与表征光刻图形保真度的指标之间的数学关系出发,通过对曝光剂量和目标图形的联合优化,提出了基于倏逝波场强衰减特性进行空间调制的近场光学邻近效应矫正(Near-field optical proximity correction,OPC)的优化方法。相比于传统的OPC优化方法,该方法能够实现对近场高频倏逝波信息的空间调制,可提高优化自由度,能够更有效地提高表面等离子体光刻系统的成像及曝光图形质量,为批量生产低成本、高分辨率和高保真度的任意二维纳米图形奠定了技术基础,并为微纳米光刻加工技术的发展提供了理论支持。
3月30日,相关研究成果以Enhancement of pattern quality in maskless plasmonic lithography via spatial loss modulationh为题,发表在Microsystems & Nanoengineering上。研究工作得到中科院和中央高校基本科研业务费专项资金资助项目的支持。(来源:中国科学院大学)
相关论文信息:https://doi.org/10.1038/s41378-023-00512-4
特别声明:本文转载仅仅是出于传播信息的需要,并不意味着代表本网站观点或证实其内容的真实性;如其他媒体、网站或个人从本网站转载使用,须保留本网站注明的“来源”,并自负版权等法律责任;作者如果不希望被转载或者联系转载稿费等事宜,请与我们接洽。